Установка «Батискаф-1» предназначена для нанесения:
– пленочных покрытий электропроводящих материалов (металлы, полупроводники) и их соединений магнетронным распылением на постоянном токе (режим DC, в том числе DC импульсный, частота 1÷100 кГц) изготовленных из них мишеней в среде рабочего газа (аргон) или его смеси с реактивным газом (кислород, азот и др.);
– пленочных покрытий диэлектрических материалов ВЧ магнетронным распылением (режим RF, частота 13.56 МГц) изготовленных из них мишеней в среде рабочего газа (аргон);
– пленочных покрытий любых материалов с точки зрения их электропроводности и состава (в том числе многокомпонентных композиционных материалов) ВЧ магнетронным распылением (режим RF, частота 13.56 МГц) изготовленных из них мишеней в среде рабочего газа (аргон или его смеси с другими газами), если физико-химические свойства этих материалов позволяют изготовить мишени, пригодные для распыления.
Установка «Батискаф-1» обеспечивает проведение следующих подготовительных и технологических операций:
– загрузка напыляемой подложки на подложкодержатель;
–высоковакуумная безмасляная откачка вакуумной технологической камеры;
–предварительная ионно-плазменная очистка подложки на подложкодержателе (в том числе при закрытой заслонке подложкодержателя) при подаче отрицательного постоянного напряжения или ВЧ напряжения смещения (RF bias) в режиме:
– высоковакуумной откачки – при напуске рабочих газов (аргон, кислород) при давлении ≤5×10-2 Торр;
– форвакуумной откачки – в среде остаточных газов при давлении 1×10-2 ÷ 1×10-1 Торр (а также с поддувом рабочего газа);
– напуск рабочих газов (аргон, кислород) в разрядную область магнетронов;
–дросселирование откачки перед напуском рабочих газов для напыления;
– предварительный отпыл мишеней 2-х магнетронов на заслонку подложкодержателя;
–конфокальное магнетронное напыление пленок на подложку при вращении подложкодержателя вокруг своей оси в режимах:
– DC: любым из 2-х конфокальных магнетронов (левым или правым);
– RF: одним (левым или правым) или двумя магнетронами одновременно (каждый от своего ВЧ генератора);
– магнетронное напыление любым из 2–х конфокальных магнетронов в режиме RF с подачей отрицательного ВЧ напряжения смещения (RF bias) на подложкодержатель;
– реактивное напыление соединений (оксидов, нитридов и пр.) электропроводящих материалов на постоянном токе (режим DC, в том числе DC импульсный, частота 1÷100 кГц) со стабилизацией общего давления смеси газов (парциального давления реактивного газа) по мембранноемкостному датчику давления (работа от блока БУРГ-1).
-
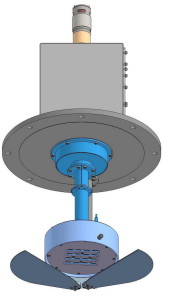
-
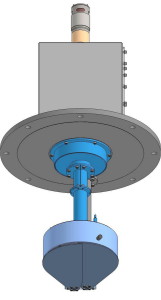
| Размеры (внутренние) вакуумной технологической камеры, мм | Сфера Ø520, усечена 6-ю портами Ду 290 |
| Размеры (внешние) вакуумной технологической камеры между присоединительными портами (длина×ширина×высота), мм | 470×470×470 |
| Скорость откачки спирального насоса, л/сек | 9.7 |
| Скорость откачки турбомолекулярного насоса, л/сек | 230×2 |
| Предельное остаточное давление в вакуумной камере, Торр (Па) | <1×10-5 (<1.33×10-3) |
| Дроссельная заслонка на 2 положения: открыто/закрыто | есть |
| Максимальный диаметр подложкодержателя/загружаемой подложки на подложкодержателе, мм | Ø165/≤Ø150 |
| Скорость вращения подложкодержателя, об/мин | 60 |
| Расход газа по каналам напуска (РРГ): | |
| – аргон (100% шкалы), л/час; | 3.6 |
| – кислород (100% шкалы), л/час; | 1.8 |
| Параметры процесса ионно-плазменной очистки в режиме форвакуумной откачки | |
| – для RF режима: | |
| – рабочее давление, Торр (Па); | 1×10-2÷1×10-1 |
– падающаяя ВЧ мощность, Вт; | <300 |
– отраженная ВЧ мощность, % | ≤1 |
| – для DC режима: | |
| – рабочее давление, Торр (Па); | 1×10-2÷1×10-1 |
| – напряжение разряда, В; | ≤-1000 |
| – ток разряда (в аргоне), мА | ≤100 |
| Параметры процесса ионно-плазменной очистки в режиме высоковакуумной откачки (с дросселированием): | |
| –для RF режима: | |
| – рабочее давление, Торр | ≤5×10-2 |
| – прямая ВЧ мощность, Вт; | <300 |
| – отраженная ВЧ мощность, % | ≤1 |
| – для DC режима: | |
| – рабочее давление, Торр; | ≤5×10-2 |
| – напряжение разряда, В; | ≤-1000 |
– ток разряда, мА | ≤100 |
| Размеры мишеней магнетронов: | |
| – диаметр, мм (дюйм); | Ø50÷Ø50.8(2”) |
| – толщина, мм (дюйм) | 3÷6.25(0.25”) |
| Параметры процесса напыления: | |
| –для RF режима: | |
| – рабочее давление, Торр | 1×10-3÷5×10-2 |
| – прямая ВЧ мощность, Вт; | <300 |
| – отраженная ВЧ мощность, % | ≤1 |
| – для DC режима: | |
| – рабочее давление, Торр; | 1×10-3÷5×10-2 |
| – напряжение разряда, В; | ≤-1000 |
| – ток разряда, мА | ≤1.5 |
| – диапазон регулирования частоты импульсов/шаг регулирования, кГц/Гц | 1÷100/1 |
| – диапазон регулирования длительности положительного импульса/шаг регулирования, мкс | 3÷50/1 |
| Толщина напыляемых пленок, мкм | 0.0001÷10.0 |
| Относительная неравномерность толщины пленок (для подложки 76 мм), % | ±2.5 |
| Параметры сети эл/питания: | |
| – напряжение, В; | 380/220 |
| – частота, Гц | 50 |
| Максимальная мощность, потребляемая установкой не более, кВА | 5 |
| Расход воды на охлаждение (температура 20±5°С, давление 4÷6 бар), л/мин | не менее 6 |
| Габаритные размеры установки (длина×ширина×высота): | |
| – стойка вакуумная, мм; | 1176×900×2000 |
| – стойка питания и управления, мм: | 600×600×1610 |
| – безмасляный форвакуумный насос, мм: | 443×288×397 |
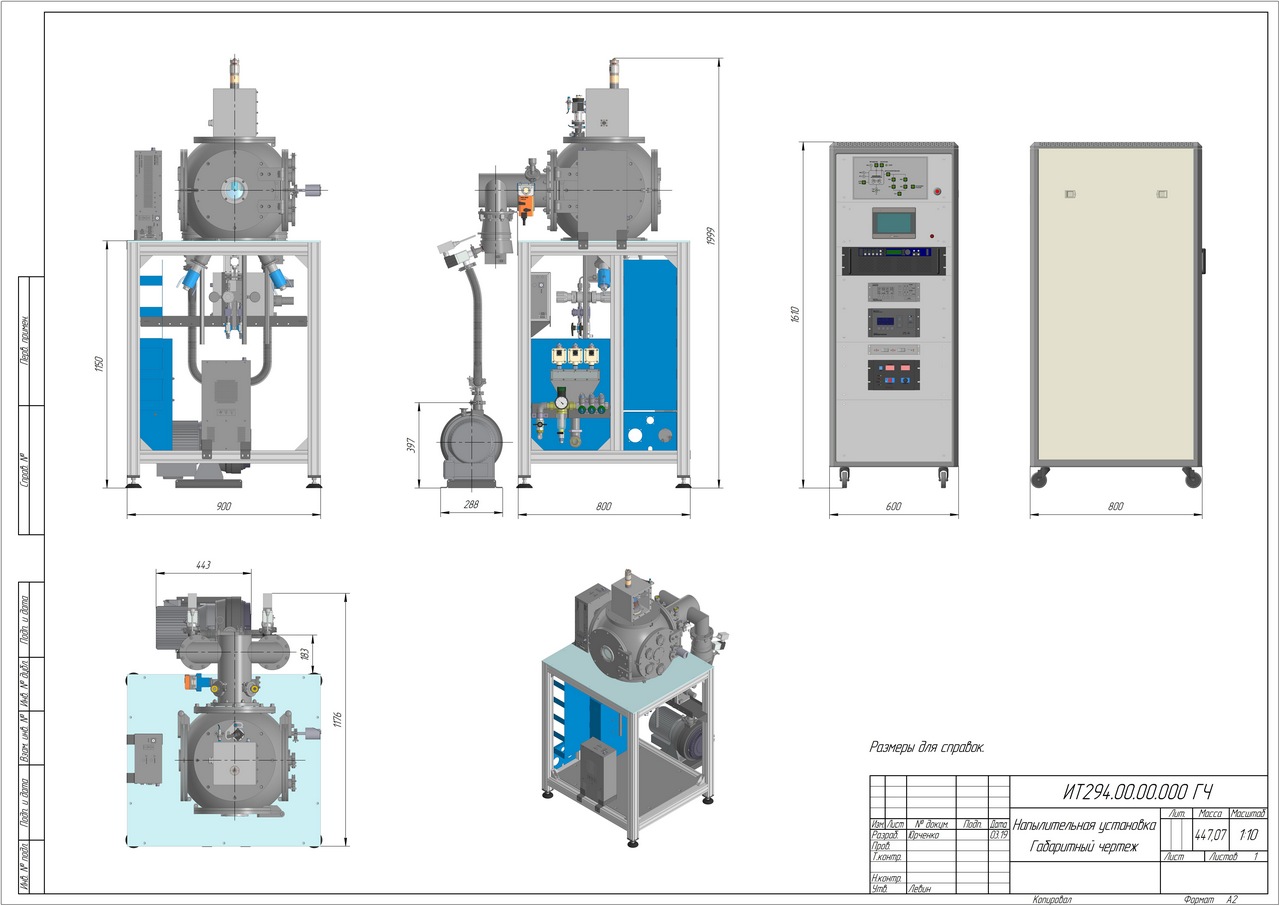
К списку продукции